攻克30微米微孔镀膜难题——振华真空TGV深孔镀膜解决方案
随着先进封装技术的发展,TGV(Through Glass Via)正逐步成为玻璃基板互连的重要方案。凭借低介电损耗、热稳定性好、加工精度高、绝缘性能强等优势,TGV在光通信、MEMS、传感器及高速互连等领域表现突出,并正加速渗透到更多高端应用场景中。
然而,TGV结构的演进也带来了新的制造挑战:孔径趋小、结构更复杂、深宽比不断提高。尤其在30微米孔径、深宽比超过10:1的条件下,要在通孔内部均匀沉积种子层,一直是行业公认的难题。这一环节虽不显眼,却直接影响器件的电气性能与长期稳定性。
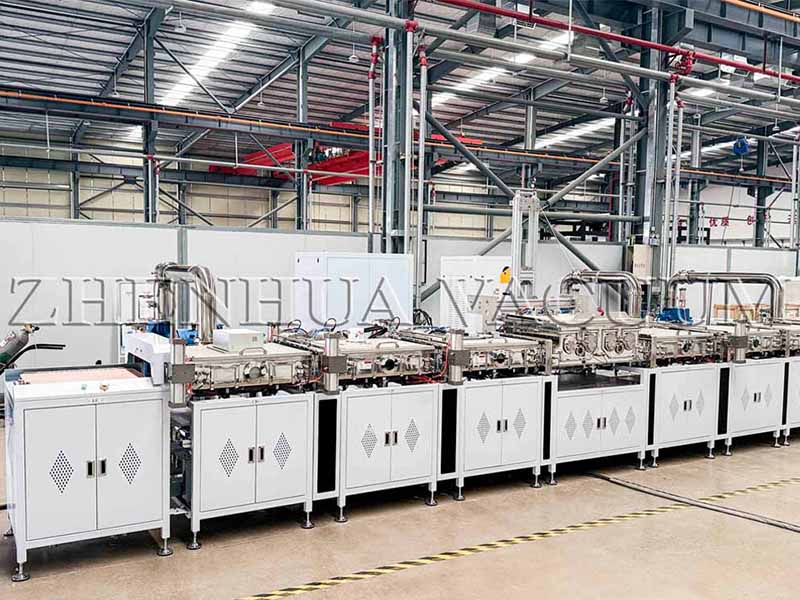
一.当前微孔镀膜的挑战
在TGV与TSV等工艺中,常见通孔直径可低至30微米,深宽比要求超过10:1。在此条件下,传统镀膜方法普遍面临:
l 沉积死角:孔壁阴影效应易导致膜层不连续,影响导电与密封性能。
l 膜厚不均:孔底与孔口沉积速率差异显著,易造成局部电阻过高。
l 多材料兼容性不足:在玻璃或硅基材上同时沉积Cu、Ti、W、Ni、Pt等多种膜材时,膜层附着力与均匀性难以兼顾。
这些问题直接影响成品良率,增加返工风险和制程成本,并限制了量产效率。
二.振华真空通孔镀膜设备解决方案
设备优势:
1.深孔镀膜优化
独家深孔镀膜技术:振华真空自主研发的深孔镀膜技术,即便是面对仅 30 微米的微小孔径,也能实现优于 10:1 深宽比,攻克复杂深孔结构的镀膜难题。
2.按需定制,支持不同尺寸
支持不同尺寸的玻璃基板,包括600×600mm /510X515mm或更大规格加工。
3.工艺灵活性,适配多种材料
设备兼容Cu、Ti、W、Ni、Pt等导电或功能性薄膜材料,满足不同应用导电与耐腐蚀需求。
4.设备性能稳定,维护方便
设备配备智能控制系统,实现自动参数调节、实时监测膜厚均匀性;采用模块化设计,维护方便,降低停机时间。
应用范围:可用于 TGV/TSV/TMV 先进封装,能实现深宽比10:1的深孔种子层镀膜。
三.结语
随着先进封装市场的持续增长,微孔与高深宽比结构的比例将进一步提升。振华真空深孔镀膜技术的应用,为应对TGV等新型封装工艺的镀膜难题提供了可量产、可扩展的解决方案,有助于提升封装效率与成品一致性。
——本文由TGV通孔镀膜设备厂家振华真空发布。